Расчет порогового напряжения МДП-структуры с учетом парциальных зарядов подвижных носителей заряда. Пороговое напряжение график2.11. Пороговое напряжение мдп транзистораПороговым напряжением МДП транзистора называется такое напряжение на затворе, при котором концентрация подвижных носителей, индуцированных в инверсном канале под затвором, равна концентрации примеси в подложке. Принимается, что проводимость в индуцированном канале появляется после того, как потенциал на поверхности достигнет потенциала инверсии. Для n-канального транзистора на p-подложке с концентрацией акцепторовпотенциал инверсиии (2.9) примет вид . Здесь – заряд подвижных носителей в канале, а– заряд акцепторов:
где – ширина ОПЗ под инверсным каналом,– диэлектрическая проницаемость кремния в отличие отдля. Обычно пренебрегают зависимостью заряда поверхностных состояний от поверхностного потенциала, считая, что этот заряд уже учтен в напряжении плоских зон. Используя (17) с , можно получить . Пороговое напряжение (2.11) Линейная зависимость описывается емкостью подложки , где - ширина ОПЗ в подложке (2.12) - линейный коэффициент влияния подложки. 2.12. Вольт-амперная характеристика мдп транзистораВыражение для дрейфового тока стока может быть получено интегрированием исходного равенства в пределах от на истоке придона стоке при– длина канала,– ширина канала. В таком выражении– часть поверхностного потенциала, создаваемая стоковым напряжением. Стоковый потенциал создает тянущее поле для электронов и одновременно уменьшает заряд электронов вдоль канала тем, что увеличивает потенциал канала и поэтому уменьшает напряжение между затвором и каналом. Кроме этого, потенциал канала увеличивает заряд акцепторов под каналом. , . Используя понятие линейного коэффициента влияния подложки , имеем , здесь определяется уже выражением (2.12). Интегрирование дает в крутой области (2.13) Граница крутой и пологой областей, когда вблизи стока и в пологой области , (2.14) удельная крутизна Подложка действует вполне аналогично затвору в полевом транзисторе с управляющим p-nпереходом. Обратное напряжение на переходе исток-подложкарасширяет ОПЗ под каналом и подзапирает канал, индуцированный полем основного, изолированного затвора. На рис. 26 показаны типичные вольтамперные характеристики МОП транзистора в крутой и пологой областях. 2.13. Конструктивные разновидности мдп транзисторовЗа сорокалетие развития технологии МДП схем конструкции и технология МДП транзисторов претерпели существенные изменения. Сформировались несколько самостоятельных научно-технических направлений разработки и применения МДП транзисторов. Среди них:
Некоторые конструктивно-технологические направления требуют хотя бы краткого обсуждения, поскольку они представляют общетехнический интерес.
Рис. 26. Типичные ВАХ МОП транзистора в крутой и пологой областях Параметры транзистора: = 0.1 мА/В2, = 0.7 В,= 0.5 В, = 0.3. 2.13.1. Мощные моп транзисторыМощные МОП транзисторы составляют отдельное направление силовой полупроводниковой электроники. На рис.27 представлена структура мощного вертикального IGBJтранзистора, который представляет собой объединение входного транзистора с изолированным затвором и выходного биполярного транзистора, ток истока входного транзистора подается в базу мощного выходного транзистора. Малая длина канала, большая крутизна и ток сочетаются с большим допустимым напряжением на коллекторе и стоке, т.к. область обеднения распространяется в слаболегированнуюn–область и большое напряжение на стоке не вызывает смыкания канала и лавинного пробоя.
Рис. 27. Структура и эквивалентная схема IGBJ транзистора E, S - эмиттер BJ и исток IG транзистора; C, D - коллектор BJ и сток IG транзистора; G – затвор IG транзистора. studfiles.net Расчет порогового напряжения МДП-структуры с учетом парциальных зарядов подвижных носителей зарядаДля большинства элементов и приборов на основе МДП-структур одним из важнейших параметров является пороговое напряжение [1]. Точный расчет этого параметра затруднен в связи с неопределенностью значений встроенного заряда в диэлектрике и распределения поверхностных состояний на границе раздела диэлектрик — полупроводник. Поэтому для достижений расчетного значения используют подгонку параметра с помощью ионной имплантации [1]. Но одновременно с пороговым напряжением происходит изменение других параметров и характеристик структуры. Наиболее негативное влияние ионная имплантация оказывает на поверхностную подвижность носителей заряда, которая уменьшается с увеличением дозы. Это ухудшает функциональные возможности элементов. Снижение подвижности в МДП-транзисторе уменьшает крутизну передаточной характеристики, граничную рабочую частоту элемента, ухудшает статические и динамические характеристики. У приборов с зарядовой связью также возрастают потери информационного сигнала. Снижение дозы ионной имплантации возможно за счет уточненного расчета значения порогового напряжения еще на ранних стадиях проектирования МДП-структуры. Для формирования структуры используют однородно легированную полупроводниковую подложку, поэтому достаточно рассмотреть одномерную модель. Производители элементной базы под пороговым напряжением понимают значение напряжения на затворе, при котором в МДП-транзисторе возникает так называемый предпороговый ток, не превышающий определенного минимального значения [2]. Более универсальным, особенного на стадии расчета, является значение напряжения затвора, при котором поверхностный потенциал полупроводника соответствует началу сильной инверсии поверхности. При начале инверсии поверхностные концентрации электронов и дырок равны: ps=ns=ni. При начале сильной инверсии поверхностная концентрация неосновных носителей равна значению объемной концентрации основных носителей заряда. Тогда падение напряжения Vsc на приповерхностной области объемного заряда (ПООЗ) полупроводника должно быть равно: Vsc= (kT/q) ys = (kT/q) 2ln(λ), (1) где k — постоянная Больцмана; T — температура по шкале Кельвина; q — заряд электрона по модулю; ys — поверхностный безразмерный потенциал, отсчитанный от положения собственного уровня Ферми в нейтральном объеме; λ = p0/ni = ni/n0 — степень (уровень) легирования. Значение ys, которое определяется равенством (1), задает начало сильной инверсии (yinv). Теперь рассмотрим выражение для расчета порогового напряжения, которое часто используется в различных методиках и алгоритмах расчета:
где Vk — контактная разность потенциалов, равная разности работ выхода электрона из полупроводника и металла; Qист — заряд ПОПЗ; Qt — эффективный заряд поверхностных состояний; Qd — эффективный встроенный заряд диэлектрика. Для идеальной МДП структуры значения Vk, Qист и Qd равны нулю. Совершенствование технологии производства позволили уменьшить влияние неконтролируемых зарядов и производить расчет по модели, которая учитывает только контактную разность потенциалов. Заряд Qист рассчитывался в приближении резкого p-n перехода:
и используя равенство (1) окончательно получаем:
где N — эффективная концентрация ионизированной примеси в полупроводниковой подложке, определяющая объемную концентрацию основных носителей заряда; ε0 –диэлектрическая постоянная; εs — относительная диэлектрическая проницаемость полупроводника [2–3]. Для более корректного расчета порогового напряжения необходимо решить уравнение Пуассона с учетом заряда подвижных носителей. В результате первого интегрирования имеем следующее равенство:
и для полупроводника в равновесном состоянии: где Правило знаков для F(y) следующее: при Из уравнения (4) очевидно, что функция F(y) есть напряжённость электрического поля в ПООЗ с точностью до множителя kT/q. Используя теорему Гаусса, получим выражение для расчета поверхностной плотности заряда на границе полупроводник — диэлектрик:
Для расчета порогового напряжения через Теперь оценим, насколько оправдано предложенное усложнение. Для идеальной структуры Vk, Qd и Qt равны нулю. Тогда:
Для расчета возьмем типовые значения параметров кремниевых интегральных МОП — транзисторов при температуре 300К: толщина окисла 20 нм, λ = 103…105 [1, 4]. Результаты приведены в таблице 1. Таблица 1 Абсолютная
Для высокоомных подложек погрешность расчета является наиболее существенной. Если в выражении (2) учитывать все факторы, определяющие пороговое напряжение реальной МДП- структуры, то относительная погрешность расчета может уменьшиться, но абсолютное значение останется прежним. А именно абсолютное значение определяет дозу ионной имплантации области канала для подгонки значения Кроме того, значение абсолютной погрешности соизмеримо со слагаемыми значения напряжения плоских зон, которые определяются величинами Qt, Qd. Это означает, что при экспериментальных исследованиях этих параметров результаты и их интерпретация становятся недостоверными. Поэтому невозможно при испытаниях тестовых образцов установить истинную причину отклонения расчетных значений от экспериментальных. Усложняется и контроль технологических режимов процессов формирования МДП- структур [4]. При чем, в открытых алгоритмах САПР до сих пор используется выражение (2) [5]. Следовательно, при применении САПР для расчета и проектирования МДП — элементов желательно «перепроверить» вычисления порогового напряжения заменяя в выражение (6) Qист на
Литература:
1. Рабаи, Жан М., Чандраскан, Ананта, Николич, Боривож. Цифровые интегральные схемы. 2-е издание.: Пер. с англ. — М: ООО «И. Д. Вильямс», 2007. — 912 с. 2. http://www.elek.oglib.ru/bgl/4192/323.html 3. http://dssp.petrsu.ru/book/chapter6/part11.shtml 4. lib.yar.ru/yarcln/edoc/yarsu/pdf/190200.pdf 5. www.rodnik.ru/product/sapr/edaexpress/ moluch.ru mppz4 Проектирование КМОП
16 Методические указания к проведению практических занятий по дисциплине «Физика наноразмерных полупроводниковых структур» Семинар 4 С4. Проектирование КМОП. Пороговое напряжение План семинара С4.1 Различные определения порогового напряжения С4.2 Подпороговый ток и статическая (standby) мощность рассеяния С4.3 Рабочий ток и быстродействие МОПТ С4.4 Зависимость рабочего тока от подпорогового тока С4.5 Проектирование профиля канала С4.5.1 Анализ процесса проектирования КМОП С4.5.2 Тенденции изменения напряжения питания и порогового напряжения Литература Задание на СРС С4.1 Различные определения порогового напряжения Пороговое напряжение является ключевым параметром КМОП технологии. Рассмотрим вначале различные определения порогового напряжения и требования к нему с точки зрения технологии. Имеется несколько различных способов определения порогового напряжения МОПТ. Ранее мы следовали наиболее общему определению: напряжение на затворе, при котором выполняется условие . Преимущество этого определения заключается в простоте его включения в аналитические решения. Однако эта величина не может быть прямо измерена из экспериментальных ВАХ. С помощью экстраполяции линейного участка ВАХ до пересечения с осьюопределяется пороговое напряжение(назовем его экстраполированным), величина которого примерно навыше порогового напряжения, определяемого из условия .
Рис.С4.1 Проходная ВАХ МОПТ при низком напряжении сток-исток Второе обычно используемое определение порогового напряжения основано на подпороговых ВАХ : . (С4.1) Задавая уровень тока (скажем 50пА) можно определить пороговое напряжениетак, что. Такое определение имеет два преимущества. Во-первых, его легко экстрагировать из результатов измерения и, следовательно, метод пригоден для автоматического измерения большого числа приборов. Во-вторых, ток выключенного прибора, может быть непосредственно рассчитан, знаяи подпороговый размах. В дальнейших рассуждениях мы будем твердо придерживатьсяопределения. В общем случаезависит от температуры (температурный коэффициент), смещения подложки (коэффициент подложки), длины канала и напряжения стока (ККЭ). С4.2 Подпороговый ток и статическая (standby) мощность рассеяния По определению ток в выключенном состоянии МОПТ (подпороговый ток) – это ток утечки сток-исток, когда напряжение затвор-исток равно нулю, а напряжение сток-исток равно напряжению питания. Из выражения (С4.1) для подпорогового тока при . (С4.2) Коэффициент (С4.3) определяется как ток сток-исток при пороговом напряжении на затворе (). В наихудшем случае напряжение сток-исток транзистора в закрытом состоянии равно напряжению питания. При этом статическая мощность рассеяния будет равна. Пусть величина. Если мы желаем, чтобы в режиме ожидания мощность рассеяния СБИС чипа, содержащего 108 транзисторов, была не выше 1Вт, ток утечки одного транзистора должен быть менее 10нА. Заметим, что ток менее чувствителен к температуре (чем), так как (лишь степенная зависимость). Однако он зависит от технологии. Для 0,1мкм КМОП технологии с Å, равен примерно 1мкА () (заметим, что это число получено для пМОПТ. Ток рМОПТ примерно в 3 раза меньше вследствие более низкой подвижности дырок). Технические условия СБИС чипа обычно рассчитываются на наихудшую температуру 100°С, когда подпороговый ток много больше, чем при комнатной температуре, поскольку не толькоуменьшается с увеличением температуры, но и наклон кривой(подпороговый размах) также деградирует пропорционально. Типично величина подпорогового размахасоставляет 100мВ/декаду при 100°С. Чтобы добиться желаемого результата и сократить величину, за счет коэффициентав формуле (С4.2), величинадолжна быть по крайней мере 0,2В. Посколькуимеет отрицательный температурный коэффициент, это означает, что. Описанная картина приемлема для КМОП логических технологий. Однако в технологии динамической памяти (DRAM) требования к току утечки более строгие: . Это означаетдляDRAM выбранного прибора с . Нужно заметить, что аналитические выражения (С4.2) и (С4.3) выведены при некоторых упрощающих предположениях: длинный канал, равномерное легирование и т.д. Они могут быть использованы для установления величин в первом приближении. Более точные значения подпорогового тока для конкретного проектирования должны быть получены численным моделированием. Насколько малым может быть предел порогового напряжения, определяет также процедура термотренировки (burn-in). Термотренировка требуется для большинства СБИС технологий, чтобы выявить ранние отказы и гарантировать надежность продукции. Она обычно выполняется при повышенных температуре и напряжении, чтобы ускорить деградационные процессы. Оба эти условия понижают пороговое напряжение и увеличивают токи утечки. Поэтому процедура термотренировки должна быть спроектирована так, чтобы не подвергать приборы риску выхода из строя. С4.3 Рабочий ток и быстродействие МОПТ В то время как нижняя граница порогового напряжения обусловлена ограничением мощности в статическом режиме (подпороговый ток), верхняя граница определяется из рассмотрения рабочего тока (ток во включенном состоянии) и времени переключения. Ток в открытом состоянии МОПТ определяется в режиме насыщения как . (С4.4) Вначале рассмотрим пМОПТ в выключенном состоянии с заземленным истоком и напряжением на стоке . Если для включения МОПТ к затвору приложено напряжение, емкость узла стока будет разряжаться током(в первый момент), и напряжение стока будет уменьшаться со скоростью, определяемой выражением , (С4.5) где С – полная эффективная емкость узла стока. Тогда для приращения время переключения. Чем меньше пороговое напряжение, тем выше рабочий ток, и, следовательно, выше скорость переключения. С этой точки зрения, желательно иметь пороговое напряжение как можно меньше. Вследствие конечного времени нарастания напряжения на входе, реальный ток, который входит в уравнение разряда емкости (С4.5), несколько меньше, чем. Рис.С4.2. показывает типичный пример полученной моделированием зависимости обратной величины задержки от нормированного напряжения. Длязависимость может быть аппроксимирована выражением. Из этого выражения следует, например, что будет потеряно примерно 30% быстродействия, есливозрастет от 0,2 до 0,3.Вследствие такой высокой чувствительности отношение для быстродействующих схем (HP) обычно сохраняют .
Рис.С4.2 Обратная величина задержки в нормированных единицах в зависимости от . Точки – моделирование с помощьюSPICE. Пунктирная линия − аппроксимация по формуле . Здесьопределяется как напряжение на затворе, при котором токравен току, получаемому по формуле (С4.3). С4.4 Зависимость рабочего тока от подпорогового тока Так как выбор порогового напряжения определяется компромиссом между и, необходимо рассмотреть зависимостьот. Рис.С4.3 представляет зависимостьотпри постоянномв линейном и полулогарифмическом масштабах для облегчения считыванияи. По существу настройка порогового напряжения прибора сводится к параллельному сдвигу кривыхгоризонтально вдоль оси. Заметим, что для приращения сдвигавеличинауменьшается с коэффициентом, в то время как токуменьшается на величину, где− крутизна в пологой области (или наклон кривойпри). Фактически, чтобы максимизировать отношениедля данного, желательно сдвинуться в сторону возможно большего порогового напряжения, так чтобы весь диапазоннаходился в подпороговой области. Однако для быстродействующих КМОП этот режим нежелателен, поскольку он приводит к уменьшениюи деградации задержки вследствие паразитных емкостей.
Рис. С4.3. Зависимости в линейном и полулогарифмическом масштабе; напряжение питания. С4.5 Проектирование профиля канала Теперь мы обсудим проектирование профиля канала МОПТ, который удовлетворяет требованиям порогового напряжения и других параметров прибора, включая длину канала, напряжение питания и толщину окисла. С4.5.1 Анализ процесса проектирования КМОП Проектирование КМОП транзистора с целью его оптимизации касается выбора целого ряда параметров, связанных с различными характеристиками прибора. Выбор этих параметров подчинен также ограничениям технологии и требованиям системной совместимости. Рис.С4.4 показывает схематическую диаграмму процесса проектирования и учитываемые параметры.
Рис.С4.4 Блок-схема проектирования КМОП, учитывающая параметры прибора, ограничения технологии и технические требования схемы Различные характеристики схемы взаимосвязаны через параметры прибора, поэтому часто необходим компромисс между ними. Например, сокращение максимальной толщины слоя обеднения улучшает ККЭ, но увеличивает чувствительность к подложке; более тонкий окисел улучшает рабочий ток, но вызывает проблемы с надежностью и т.д. Нет единственного пути проектирования КМОП приборов для данного поколения технологии. Мы попытаемся здесь дать генеральный план выбора этих параметров прибора. Так как пороговое напряжение играет ключевую роль в определении и , и, важно минимизировать допуск на, то есть разброс между высоким и низким пороговыми напряжениями приборов на чипе. Доминирующим источником разброса порогового напряжения в КМОП технологии являются ККЭ. Вариации длины канала на чипе вследствие несовершенства технологического процесса увеличивают вариации порогового напряжения. Как получено на семинаре 1, пороговое напряжениекороткоканального прибора меньше, чем у длинноканального на величину , (С4.6) где . Чувствительность порогового напряжения к вариациям длины канала,, тесно связана с. Так как, в наихудшем случае, , величина квадратного корня в выражении (С4.6) находится в пределах для . Коэффициент перед скобками,, связан с коэффициентом . Величина измеряет эффективность модуляции поверхностного потенциала напряжением на затворе. Как обсуждалось ранее при рассмотрении тока насыщения, подпорогового размаха и чувствительности к подложке, величина m не должна быть много больше единицы, то есть . Вследствие экспоненциальной зависимости в (С4.6), очень чувствительно к отношению. Хорошим выбором является, что, предполагая среднее значение , дает и. Выбор необходимых параметров представлен диаграммой на плоскости проектирования рис.С4.5. Точка пересечения двух линий, (допустимая величина ККЭ) и(необходимые подпороговый размах, ток насыщения и коэффициент влияния подложки) определяет верхнюю границу толщины окисла, равную. Нижняя границаопределяется ограничением технологии, где− максимально допустимое поле в окисле из
Рис.С4.5. Плоскость проектирования . Компромисс между различными факторами может быть найден внутри области параметров, ограниченной ККЭ, эффектом подложки и толщиной окисла. соображений надежности и пробоя. Для данных L и разрешенная область параметров вплоскости проектирования представляет собой площадь треугольника с границами, определяемыми требованиями ККЭ, поля в окисле и подпорогового размаха (а также чувствительностью к подложке). В дополнение к ограничению поля в окисле меньший предел толщины окисла устанавливает также прямое квантовомеханическое туннелирование зона-зона (рис.С4.6). Плотность тока затвора резко возрастает, когда становится меньше 2нм. Из рис С4.6 следует, что плотность туннельного тока при 1нм толщине окисла и напряжении 1В составляетА/см2.
Рис. С4.6. Измеренные (точки) и промоделированные (сплошные линии) туннельные токи в МОПТ с тонким окислом и поликремниевым затвором. Пунктир показывает уровень туннельного тока 1А/см2. В предположении ток затвора отдельного транзистора (<3мкА/мкм) все ещё мал по сравнению с типичным током (≈1мА/мкм) предшествующего каскада, так что о задержке переключения активного транзистора вряд ли стоит волноваться. Но при рассмотрении 108 транзисторов, у каждого из которых , общая площадь затворов на чипе составляет . Наибольший ток утечки (наихудший случай) наблюдается при смещении и− электроны туннелируют из инверсного канала в затвор. В этом случае статическая мощность рассеяния всех включенных транзисторов на чипе достигает недопустимого уровня 10-100Вт.При использовании приведенного выше критерия , толщинаSiO2 в 1нм требует длины канала ≈20нм. Если использовать high-k диэлектрик затвора, характерная длина может быть сведена к (семинар 1) для очень высоких величин диэлектрической проницаемости, где− толщина изолятора. В этом случае минимальная длина канала может достичь, или 10нм, предполагая туннельное ограничение толщиныhigh-k диэлектрика в 2,5нм. Последняя цифра толщины больше, чем у SiO2, поскольку высота барьера high-k диэлектрика меньше, чем у SiO2 (< 3,1эВ). С4.5.2 Тенденции изменения напряжения питания и порогового напряжения Для окна проектирования, показанного на рис.С4.5, требуется, чтобы . Это определяет верхнюю границу напряжения питания, а именно, . (С4.7) Для ранней КМОП технологии с толщина окисла была относительно велика (), и. Выражение (С4.7) тогда требует. Это допускает большой простор для проектирования, позволяющий выбрать потребляемую мощность и пороговое напряжения так, чтобы удовлетворить требованиям и подпорогового тока, и характеристик, обсужденных ранее. Например,и, как показано на рис.С4.7, на котором представлены история итенденции изменения напряжения питания, порогового напряжения и толщины окисла в зависимости от длины канала КМОП логических технологий от 1мкм до 0,02 мкм. Для более коротких длин канала должно быть уменьшено. Становится все более и более трудным удовлетворить требования, предъявляемые к параметрам и подпороговому току. К счастью,имеет тенденцию увеличиваться для более тонких окислов, когда длина канала уменьшается. Это позволяет масштабироватьмедленнее, чем длину канала. Экспериментально установлено, что для окислов тоньше 3нм величина. Выражение (С4.7) в таком случае требует, например, чтобы для КМОП технологии с.
Рис. С4.7 Тенденции изменения напряжения питания, порогового напряжения и толщины окисла в зависимости от длины канала КМОП технологии от 1мкм до 0,02 мкм. При таком низком напряжении питания необходим компромисс между быстродействием и токами утечки. Уменьшение вызывает экспоненциальный рост (см. (С4.2). Даже для того же самого ток растет, так какв выражении (С4.3) увеличивается, когда прибор масштабируется вниз – проявление немасштабируемости порога. По этой причине и для совместимости со стандартным напряжением питания более ранних поколений схем,общей тенденцией является то, что не уменьшается пропорционально сокращению длины затвора, ане масштабируется пропорционально,как очевидно из рис. С4.7. При требуетсядля работы при . studfiles.net Расчёт порогового напряжения МОП транзисторов. Расчёт выходных характеристик управляющего транзистора. Передаточная характеристика инвертораФедеральное агентство по образованию Государственное образовательное учреждение высшего профессионального образования Северо-Западный государственный заочный технический университет Кафедра технологии и дизайна радиоэлектронной техники КУРСОВАЯ РАБОТА По дисциплине: Интегральные устройства радиоэлектроники Тема: Выполнил студент: Хованский Михаил Юрьевич Факультет: РЭ Курс: 4 Специальность: 210201 Шифр: 5540300077 Преподаватель: Цветов В.П. Оценка: Подпись преподавателя: Дата: Санкт-Петербург 2008 Содержание Введение Исходные данные Анализ задания Расчётная часть Заключение Библиографический список Введение Исходные данные n-МОП транзистор Концентрация акцепторных примесей в подложке NA, см – 3 5 • 1016 Толщина подзатворного оксида tox, нм 20 Длина канала L, мкм 1.0 Поперечная ширина канала W, мкм 12 Данные для расчёта нагрузочной кривой: WН 2 мкм LН 2 мкм UDD 4.5 В Постоянные: K 1.38 • 10-23 Дж/К q 1.6 • 10-19 Кулон ε0 8.85 • 10-12 Справочные величины: εi 3.9 εs 11.9 ni 1.5 • 1010 см-3 μn 0.15 Расчётная часть Расчёт порогового напряжения МОП транзисторов Пороговым напряжением UT МОП транзистора считается напряжение на затворе полевого транзистора, когда на поверхности полупроводника образуется инверсный слой проводимости, создающий проводящий канал от истока к стоку.
Сначала определим объёмный потенциал Ферми полупроводника р-типа.
Теперь найдём удельную ёмкость подзатворного диэлектрика Сох
Находим пороговое напряжение
Условие смыкания
где UP – напряжение прокола Расчёт выходных характеристик управляющего транзистора а) Таблица токов насыщения при различных значениях напряжения на затворе управляющего транзистора
Для облегчения вычислений, введём коэффициент
Значения UG: UG1 = UT = 1.28В, UG2 = 1.5UT = 1.94В, UG3 = 2UT = 2.58В, UG4 = 2.5UT = 3.23. В, UG5 = 3UT = 3.88В.
б) Семейство вольт-амперных характеристик управляющего транзистора в крутой линейной части рассчитывается по формуле
при различных значениях на затворе UG1… UG5 , а значение UDS – от 0 до UDD(напряжения питания 4,5В). При UG1= 1.28 и UDS= 0.1ВIнас= 0.019 мА
МОП транзисторы в качестве нагрузочного элемента Используя МОП транзистор как резистивный элемент в электрической схеме инвертора, можно уменьшить площадь инвертора и выделение тепла. Транзистор, используемый в качестве нагрузки, отличается от управляющего значительно большим импедансом во включенном состоянии.
Найдём UGSдля нескольких значений ID, а через UGS найдём UВЫХ как разность UDDиUGS. Пусть ID = 0.1 мА = 10 – 4 А
И снова, для облегчения вычислений, введём коэффициент
Аналогично для остальных значений
Передаточная характеристика инвертора Для построения передаточной характеристики графически решается зависимость
Время переключения инвертора Динамические характеристики переключающего устройства определяются временем включения и временем выключения управляющего транзистора. Критерий сильного поля
где CS – скорость звука
Напряженность в канале: U = 2B, L = 1 • 10-6 м
Условия сильного поля в канале выполняются. Вычисление скорости насыщения:
где hv0 из табличных данных = 0,063 эВ – максимальная энергия оптического фотона колебаний решетки Si.
где
Т.к. 1эВ = 1.6•10-19 Дж
Время пролета канала
Это время внутренней реакции необходимо сравнивать с временами заряда-разряда емкостей. Время заряда емкости CH (нагрузки) при запертом управляющем транзисторе:
Крутизна нагрузочного транзистора в области насыщения:
Время разряда нагрузочной емкости через открывающийся управляющий транзистор:
Максимальное время задержки – время заряда Список используемой литературы Аналоговая и цифровая электроника. Опадчий Ю.Ф. Полупроводниковые приборы. Пасынков В. В. Физика полупроводниковых приборов микроэлектроники. Старосельский В.И vunivere.ru mppz5 Пороговое напряжение
24 Методические указания к проведению практических занятий по дисциплине «Физика наноразмерных полупроводниковых структур» Семинар 5 С5. Пороговое напряжение и профиль канала План семинара С5.1 Влияние работы выхода затвора С5.2 Требования и тенденции профиля канала С5.2.1 Неравномерное легирование С5.2.2 Выбор порогового напряжения С5.2.3 Дельта-легирование на поверхности () С5.2.4 Дельта-легирование с С5.2.5 Контрлегирование канала С5.2.6 Латерально неоднородное легирование канала Литература Задание на СРС С5.1 Влияние работы выхода затвора Чтобы реализовать желательное пороговое напряжение, определяемое целями проектирования, важно использовать материал затвора с подходящей работой выхода. Работа выхода затвора, , сильно влияет на пороговое напряжение МОПТ, так как она определяет напряжение плоских зон (рис.С5.1). Для пМОПТ при заряде в окисле напряжение плоских зон и пороговое напряжение определяются выражениями (С5.1) (С5.2) Для пМОПТ величина и, так что несомненно больше, чем 1В, покане сильно отрицательно. Чтобы достичь низкого порогового напряжения (менее 1В), используетсяп+-поликремниевый
Рис.С5.1 Энергетическая диаграмма МДП структуры в равновесном состоянии: а – полупроводник п-типа, в – полупроводник р-типа затвор для пМОПТ, так что . Этот результат близок к взаимному уничтожению первого и второго членов выражения (С5.2). Тогда в значительной степени определяется третьим членом, пропорциональным плотности заряда обеднения при условии. Как должен быть спроектирован профиль примеси, чтобы достичь желаемой плотности заряда обеднения и, следовательно,, обсуждается в следующих разделах. В 1мкм и 0,5мкм поколениях технологии рМОПТ также использовался п+-поликремниевый затвор. Для рМОПТ с п+-поликремниевым затвором . Это означает, что − малое отрицательное число (для кремнияп-типа) и первые два члена выражения (второй член для рМОПТ) в сумме дают <(−1В) для рМОПТ. Чтобы сделать менее отрицательным, третий член в выражениидолжен быть положительным, что означаетр-тип легирования канала для рМОПТ. Это достигается достаточно сильным легированием поверхности бором, так что тип её проводимости становится противоположен типу проводимости подложки (контрлегирование канала). Если этот поверхностный слой не полностью обеднен, возникает некоторая нейтральная область р-типа – скрытый канал, соединяющий области стока и истока (рис.С5.2). Такой прибор называется МОПТ со скрытым каналом. Напряжение затвора может изменять толщину поверхностного обедненного слоя, контролируя толщину канала и протекающий через него ток. При достаточно большом отрицательном смещении канал полностью открыт, и может возникнуть дополнительный инверсный слой (поверхностный канал), так что два канала включаются параллельно.
Рис.С5.2. Структура рМОПТ со скрытым каналом Подвижность носителей в скрытом канале на примерно 15% выше, чем у поверхности, и, следовательно, прибор со скрытым каналом имеет несколько больший рабочий ток по сравнению с МОПТ с поверхностным каналом. Однако это преимущество перевешивается некоторыми недостатками МОПТ со скрытым каналом. Во-первых, прибор со скрытым каналом более чувствителен к ККЭ, чем прибор с поверхностным каналом. Это есть следствие контрлегирования (особенно бором) на поверхности, создающее тенденцию диффузии бора глубоко в кремний во время последующих термических циклов процесса. При масштабировании требуется меньшая величина порогового напряжения. Это требует более сильного контрлегирования канала, что неизбежно приводит к более широкому обедненному слою затвора и усугублению ККЭ. Во-вторых, раз носители в канале находятся дальше от поверхности, то они хуже контролируются напряжением затвора. Поэтому для достижения того же рабочего тока требуется большее напряжение затвора, чем в случае поверхностного канала. И наоборот, чтобы достигнуть той же самой степени выключения МОПТ требуется меньшее напряжение затвора, чем в случае поверхностного канала. Следовательно, характеристики выключения будут менее резкими, что означает, что подпороговый размах S будет больше. Большая величина S означает большой ток в закрытом состоянии, особенно при высоких напряжениях стока. Поэтому МОПТ со скрытым каналом в современных технологиях не используются. Для КМОП логических технологий с длиной канала 0,25мкм и меньше используются дуальные поликремниевые затворы (п+-поликремниевый затвор для пМОПТ и р+-поликремниевый затвор для рМОПТ), так что оба типа приборов имеют поверхностный канал. Проводились многочисленные исследовательские работы по использованию металлических затворов с работой выхода, отсчитываемой от середины запрещенной зоны кремния (midgap work function). Преимущества: высокая проводимость затвора, отсутствие эффекта обеднения поликремния и простота использования одного и того же материала для п- и рМОПТ. Затвор с midgap-работой выхода создает симметрию напряжений плоских зон (р-тип) для пМОПТ и (п-тип) для рМОПТ. В результате величины порогового напряжения находятся в диапазоне 0,5-1,0В. Это соответствует требованиям для 1мкм и 0,5мкм технологий КМОП на рис.С4.7 (семинар 4). Добавочная выгода в том, что требуется намного меньше заряда обеднения [третий член в выражении (С5.1)], чтобы достигнуть тех же самых величин сmidgap-затвором, чем с п+-поликремниевым затвором для пМОПТ. Меньший заряд обеднения означает меньшие поверхностные поля и, следовательно, более высокую подвижность. В действительности, однако, никакой материал для midgap-затвора не используется в продукции СБИС вследствие технологических проблем совместимости материала затвора с тонким подзатворным окислом. Как только КМОП технология масштабировалась до 0,25 мкм и ниже, потребовалась величина (рис.С4.7), которую трудно достичь с midgap-затвором. С5.2 Требования и тенденции профиля канала Как обсуждалось выше, для пМОПТ с п+-поликремниевым затвором (и р+-поликремниевым затвором для рМОПТ) первый и второй члены в выражении (С5.1) по существу взаимно уничтожаются, и в основном определяется членом с зарядом обеднения. Для равномерно легированного канала при условии максимальная толщина обедненного слоя (С5.3) и член с зарядом обеднения в выражении для порогового напряжения , (С5.4) связаны через параметр и, следовательно, не могут изменяться независимо (для данной толщины окисла ). Ранее мы обсуждали, что для того, чтобы контролировать ККЭ, величинадолжна быть порядка.Концентрация примеси, которая соответствует этому требованию, и одновременно обеспечивает желаемое пороговое напряжение, удовлетворяющее требования подзатворного и рабочего токов, не может быть реализована на практике. Действительно, полагая величину =1нм,,приm =1,4, получаем из (С5.3): . Для данного необходимо использовать неравномерный профиль легирования, чтобы создать плотность заряда обеднения, требуемую для получения желаемого . Неравномерный профиль легирования дает проектировщикам прибора дополнительную степень свободы для подгонки профиля, соединяющего требования ККЭ и порога. Такая оптимизация возможна с помощью технологии ионного легирования. С5.2.1 Неравномерное легирование Математически поверхностный потенциал, электрическое поле и пороговое напряжение для случая неравномерного легирования могут быть найдены из решения уравнения Пуассона в предположении полного обеднения. Для неравномерно легированного профиля примеси р-типа с осьюх, направленной нормально к поверхности и началом координат на поверхности, электрическое поле получается интегрированием уравнения Пуассона (пренебрегая зарядом подвижных носителей в обедненной области):
,(С5.5) где − толщина обедненного слоя. Интегрируя ещё раз, получаем поверхностный потенциал .(С5.6) Интегрируя по частям, получаем (С5.7) Интеграл от равен центру масс функциивнутри интервала (0,Wd) интеграла от . Максимальная толщина обедненного слоя (длинный канал) определяется условием , когда : −(С5.8) интеграл, управляющий величиной порогового напряжения, и −(С5.9) интеграл, управляющий величиной . Таким образом, пороговое напряжение неравномерно легированного МОПТ определяется двумя интегралами: плотность заряда обеднения (С5.8) и центр масс функции внутри интервала (0,Wd) (С5.9). С5.2.2 Выбор порогового напряжения
Рис. С5.3. Проходная характеристика МОПТ Выбор порогового напряжения определяется:
Соотношение между иопределяется типом схемы. Например, для быстродействующих схем (high-performance logic – HP) ITRS 2008 устанавливала следующие параметры прибора:
. Для маломощных схем (low standby logic – LSP):
. Рассмотрим, каким образом профиль легирования канала влияет на пороговое напряжение. Начнем с рассмотрения равномерного профиля со ступенчатым изменением концентрации примеси (рис. С5.4). Из решения уравнения Пуассона
при пороговом напряжении на затворе следует ,, и. ,
Рис. С5.4 Распределение плотности заряда (а) и электрического поля (б) для двух равномерных профилей примеси в подложке. Таким образом, при равномерном профиле легирования: 1) Концентрация примеси определяет и. 2) При уменьшении концентрации примеси растет и уменьшается. 3) практически нечувствительно к. Как было установлено на семинаре 4, величина контролирует ККЭ. Необходимо, чтобы . Величина контролирует пороговое напряжение. Для пМОПТ: , где Обе величины, и, определяются концентрацией примеси: ,
Выводы:
С5.2.3 Дельта-легирование на поверхности () Предполагаем подложку р-типа () (рис.С5.5). Считаем имплантированный заряд расположенным на поверхности кремния в виде дельта-функции , причем доза . По закону Гаусса , где − полный заряд в полупроводнике, равный заряду ионов в объеме и на поверхности. Поле в точке (0+) определяется только ионами акцепторов. Поле в диэлектрике (0-) определяется зарядом в объеме и на поверхности полупроводника. На рис С5.5. предполагается положительный заряд имплантированных ионов.
Рис. С5.5 Распределение плотности заряда (а) и электрического поля (б) для профиля примеси с дельта-легированием на поверхности подложки. Таким образом, при дельта-легировании на поверхности: 1) Толщина обедненной области не зависит от дозы и определяется только концентрацией примеси в подложке: . 2) Пороговое напряжение зависит от дозы: . Сдвиг порогового напряжения . 3) иможно выбирать независимо друг от друга: а) выбираем для выполнения условия; б) выбираем для получения желаемого. С5.2.4 Дельта-легирование с Предполагаем подложку р-типа ().
Рис. С5.6 Распределение плотности заряда при дельта-легирование с Найдем распределение электрического поля из уравнения Пуассона:
Решаем задачу методом суперпозиции. Электрическое поле от заряда ионов в подложкеравно
Это поле создает поверхностный потенциал . Таким образом, равно площади под функцией− площади треугольника.
Рис. С5.7 Распределение плотности заряда (а) и электрического поля (б) от зарядов ионов в подложке. Рис. С5.8 Распределение плотности заряда (а) и электрического поля (б) от зарядов имплантированных ионов. Аналогично находится электрическое поле от имплантированного положительного заряда(рис.С5.8). По закону Гаусса . Знак минус означает, что поле направлено против осих. равно площади прямоугольника: . Результирующий изгиб зон равен . Решая это уравнение относительно , находим: , . Тогда пороговое напряжение
Результирующее распределение поля получается суперпозицией полей и(вычитание площади прямоугольника из площади треугольника) − рис.С5.9. Из рисунка и формул следует, что при дельта-легировании с : 1) уменьшается, 2) уменьшается, 3) Если , изменяются как, так и. Приполучаем большие измененияи малые изменения(случайС5.2.3). Рассмотрим теперь ступенчатое изменение распределения примеси – спадающий профиль (рис.С5.10).
Рис. С5.9 Результирующее распределение поля при дельта-легировании с .
Рис. С5.10 Распределение примеси и электрического поля при спадающем ступенчатом профиле. Решение дает: (1) (2) Результат: меньше, абольше, чем при равномерном легировании.Имеется некоторая неопределенность в том, через какую концентрацию определять − черезили. Мы условимся, что всегда определяется относительно концентрации в подложке на конце обедненной области,то есть . На самом деле имеет малое значение, какую концентрацию мы используем, посколькуслабая функция концентрации. Дальнейшее уточнение условия порога потребовало бы численного моделирования для конкретного профиля. Тот же результат можно получить, если заменить заряд на отрезке зарядом дельта-функции, расположенной в точке(рис.С.5.11). studfiles.net 9.4. Влияние смещения на подложке на пороговое напряжение основного каналаТак же, как и в МОПТ объемной технологии, пороговое напряжение может управляться напряжением на подложке (нижнем затворе). Как уже отмечалось выше, сильнолегированный контакт подложки можно рассматривать как своеобразный нижний затвор, который может быть использован для юстировки порогового напряжения основного канала. Напряжение на нижний затвор подается относительно заземленного истока, причем, в отличие от объемного МОПТ, диэлектрическая изоляция позволяет любую полярность напряжения. При прикладывании положительного напряжения VGB к нижнему затвору относительно истока количество элек- тронов в базе растет, и, соответственно, уменьшается пороговое напряжение верхнего транзистора. Изменение порогового напряжения относительно истока VTF=VTF(2ϕF+VGB)−VTF(2ϕF)−VGB=
Коэффициент электрической связи двух затворов ηFD по своему физическому смыслу приблизительно соответствует коэффициенту влияния подложки в транзисторах объемной технологии. Если мы имеем очень тонкий скрытый окисел, то C2 >> CS , и сдвиг порога аналогичен сдвигу порога при приложении обратного положительного смещения на подложку в объемной технологии, где CS играет роль удельной емкости обедненного слоя в объемной технологии (ср. п. 4.8). Рис. 9.3. Зависимость порогового напряжения для верхнего затвора VTF от напряжения на нижнем затвореVBG для частично обедненного (ν) и полностью обедненного (λ) тела. Наклон зависимости в линейном участке должен соответствовать значениюηFD 9.5. Вырожденный каналДля описания электронов в канале МОПТ ранее мы всегда пользовались формулами для невырожденного электронного газа в отсутствие квантования. Вообще говоря, это не совсем правильно. Инверсионный слой МОП транзисторов представляет собой полностью либо частично вырожденную систему с поперечным квантованием и частичным заполнением несколько подзон (см. главу 1). Учет этого обстоятельства для вычисления, например, поверхностной плотности носителей в канале требует самосогласованного решения уравнения Шредингера и Пуассона, что на практике никогда не делается без особого ущерба для описания, например, вольтамперных характеристик МОПТ. Действительно, рассматриваемые квантовые эффекты слабо влияют на вид ВАХ МОПТ, поэтому они даже формально не заложены в структуру моделей (например, BSIM4). Для того чтобы показать, почему такое происходит, будем рассматривать в этой главе модель полностью вырожденного газа электронов с заполнением одной подзоны, что, вообще говоря, является столь же грубым приближением, как и больцмановское приближение квазиобъемного канала. 215 Для двумерного случая заполнения одной подзоны имеем (см. главу 1)
Используя эти соотношения, удельную квантовую емкость инверсионного слоя можно выразить непосредственно через плотность электронов
Для описания диффузионного тока при вырождении введем
которую в случае строго двумерной системы можно представить в виде
Очевидно, что энергия диффузии равна температуре εD kBT для невырожденного канала (ζ < 0) и энергии Ферми εD = qζ = εF = mvF2 2 для вырожденного канала(ζ > 0). Аналогично (9.5.2) энергию диффузии для заполнения одной подзоны можно представить как функцию плотности электронов в канале
Формально соотношения (9.5.6) и (9.5.1) описывают асимптотически не только вырожденный случай, когда для большой плотности носителей в канале имеем εD nS g2D εF , но и невырожден- ный канал, когда для малой плотности носителей в канале становится справедливой статистика Больцмана и εD kBT . К сожалению, формула (9.5.6) не дает правильного описания εD (и связанных с ним емкости инверсионного слоя и концентраций) для промежуточного случая, когда происходит переход от одноподзонного заполнения к многоподзонному с последующим пределом в форме квазиобъемного канала. Точное описание эффектов заполнения инверсионного слоя для всего диапазона концентраций в канале лежит за пределами возможности аналитических моделей. Энергия диффузии является важной характеристикой, поскольку входит в соотношение Эйнштейна в форме, которая остается справедливой как для вырожденной, так и для невырожденной статистики:
Как и ранее, будем приближенно считать, что κ иεD являются функциями только смещений на затворе и не зависят от координаты вдоль длины канала. 9.6.Уравнение непрерывности для плотности тока вканале Ключевым пунктом рассматриваемого подхода является аналитическое решение уравнения непрерывности для плотности тока в канале dyd ((1 +κ )σS E(y))= 0 . В этой главе будет использовано соглашение о знаке химического потенциала, для которого электрохимический потенциал выражается формулой μ = qϕ − qζ . Тогда с учетом приближения независимости κ отy уравнение непрерывности для плотности тока принимает вид
где εD = qnS dζ dnS – энергия диффузии (см. главу 1) Соотношение диффузионного и дрейфового тока в канале ПО КНИ МОПТ определяем, рассматривая ϕS иζ как независимые studfiles.net Что такое пороговое напряжение? - Ремонт интерьер строительствоПороговое напряжениеПороговое напряжение — это точка, в которой электрическое устройство настроено для активации любой из своих операций. Обычно это происходит в транзисторе, который постоянно контролирует источник питания для изменений, игнорируя те, которые слабы или непреднамеренно просочились через систему. Как только заряд входящего электричества будет достаточным для соответствия установленному стандарту, пороговое напряжение будет удовлетворено, и для его включения разрешается протекать по всему устройству. Все, что находится ниже предопределенного порога, содержится и рассматривается как фантомный заряд. Хотя определение порогового напряжения в устройстве с одной схемой может показаться относительно простым и простым, современная электроника требует довольно сложной математической формулы для установки и регулирования различных пороговых значений. Например, прибор, например, посудомоечная машина, может быть запрограммирован на выполнение 20 или более функций, зависящих от повседневных требований пользователя, и каждая отдельная фаза, в которую он входит, активируется электрическим зарядом. Эти незначительные изменения в мощности позволяют устройству знать, когда добавлять больше воды, когда активировать механизм сушки или как быстро вращать чистящие струи. Каждое из этих действий устанавливается на отдельное пороговое напряжение, поэтому, когда сразу необходимо активировать несколько элементов, для этого требуется много планирования для обеспечения правильной работы. Уравнение для расчета порогового напряжения представляет собой сумму статического напряжения, плюс вдвое больше объемного потенциала и напряжения на оксиде. Пороговое напряжение обычно создается с помощью тонкого инверсионного слоя, который отделяет изоляционное и фактическое тело транзистора. Крошечные отверстия, которые положительно заряжены, покрывают поверхность этой области, и когда электричество подается, частицы в этих пустотах отталкиваются. Как только ток в пределах внутренней и внешней областей будет уравнен, транспондер позволяет высвободить энергию для завершения схемы, которая активирует процесс. Весь этот процесс завершается в течение миллисекунд, и транзистор постоянно перепроверяет, чтобы гарантировать, что текущий ток оправдан, подрывая мощность, когда это не так. Другим термином, который используется при разговоре о транспондерах, является пороговое напряжение полевого транзистора (МОП-транзистора) из оксида металла. Эти проводящие переключатели спроектированы с положительными или отрицательными зарядами, как в приведенном выше примере, и они являются наиболее распространенным типом транзистора в аналоговых или цифровых устройствах. Транзисторы MOSFET первоначально были предложены в 1925 году и были построены на основе алюминия вплоть до 1970-х годов, когда кремний был обнаружен как более жизнеспособная альтернатива. voltstab.ru | |||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
||||||||||||||||||
|
|
||||||||||||||||||
|




 , (2)
, (2) ,
, , (3)
, (3) , (4)
, (4) , (5)
, (5) — длина Дебая собственного полупроводника.
— длина Дебая собственного полупроводника. , и наоборот.
, и наоборот. . (6)
. (6) необходимо задать значение ys в выражениях (5–6) равным
необходимо задать значение ys в выражениях (5–6) равным  и заменить в выражение (2) Qист на
и заменить в выражение (2) Qист на  . (7)
. (7) и относительная
и относительная  погрешности расчета порогового напряжения
погрешности расчета порогового напряжения .
.








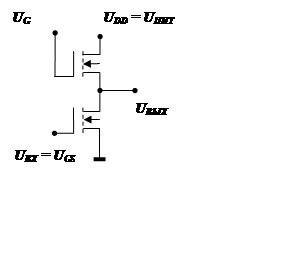 рис.1
рис.1






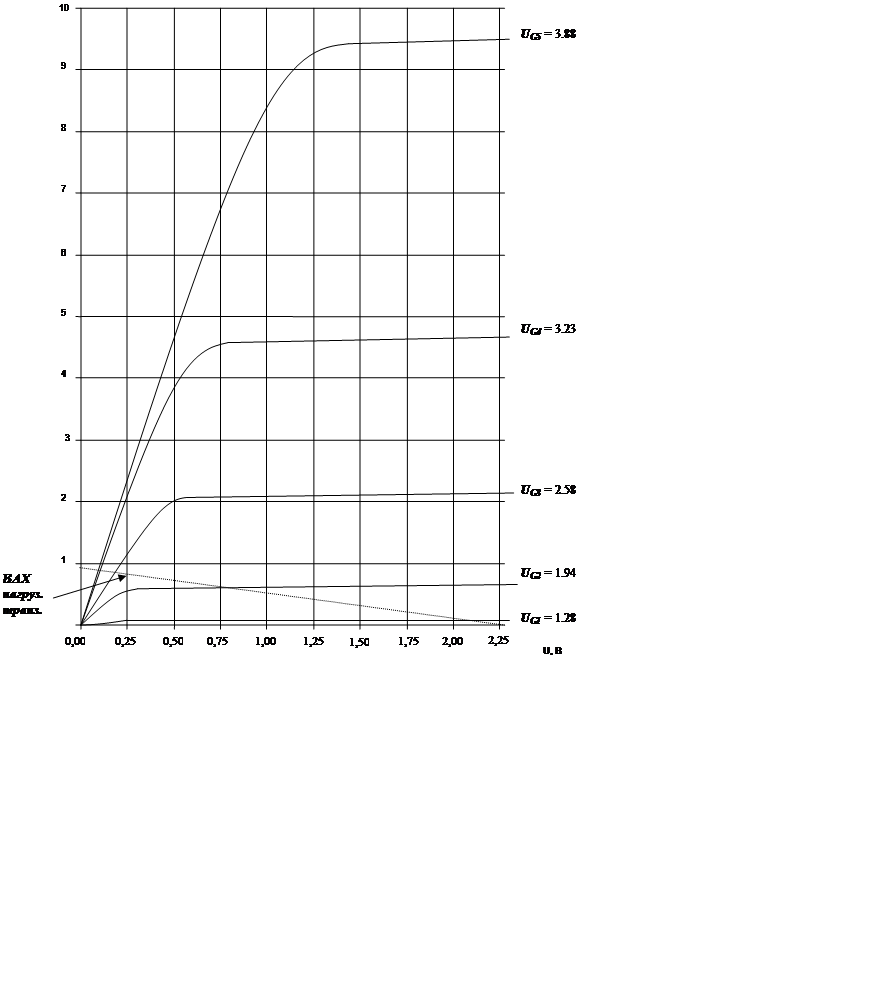

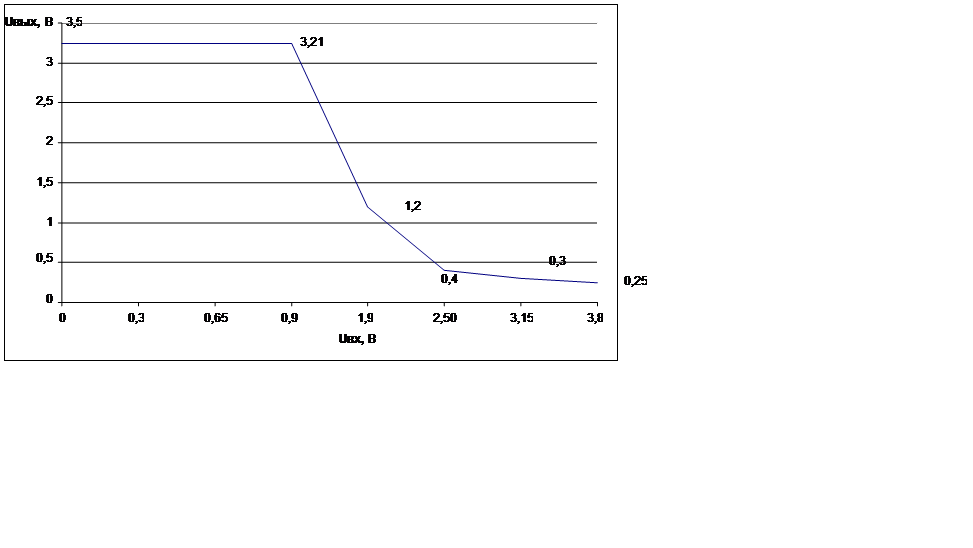




 – эффективная масса носителя
– эффективная масса носителя = 0,91 • 10-30 кг – масса электрона
= 0,91 • 10-30 кг – масса электрона
 = 0,98 – продольная эффективная масса электрона
= 0,98 – продольная эффективная масса электрона = 0,19 – поперечная эффективная масса электрона
= 0,19 – поперечная эффективная масса электрона



 Ф
Ф






 -
- 







